\ 首頁 ・產品應用・成型機
AOI系列-Die Level Package

熱光學檢查機(Thermal Optical AOI)
【用途說明】
【特性說明】
| ● | 此量測系統應用3DIC,可檢出Bump/Pad 受熱後之位移狀況,以利產品設計。 |
【特性說明】
| ● | 非接觸式加熱。 |
| ● | 可支援加熱前後量測值圖像比對。 |
| ● | 可自動生成報表。 |
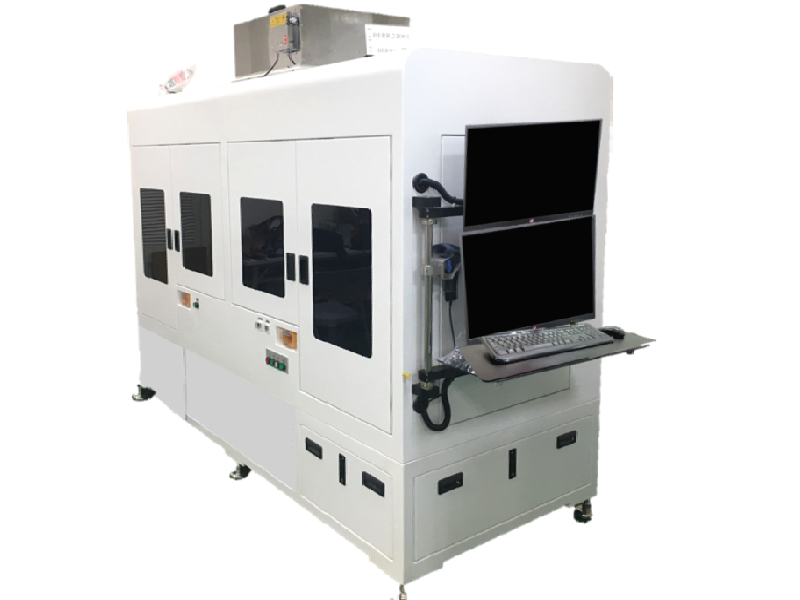
HBM Incoming AOI
【用途說明】
【特性說明】
| ● | 針對HBM元件,捲帶進料之檢查。 |
【特性說明】
| ● | 可拆捲獨立取出六面檢查。 |
| ● | 可量測產品之斜切(Slant) 。 |
| ● | 前後顆產品圖像比對。 |
| ● | 可自動生成報表。 |
| ● | 支援SWIR進行內裂與隱崩檢查。 |
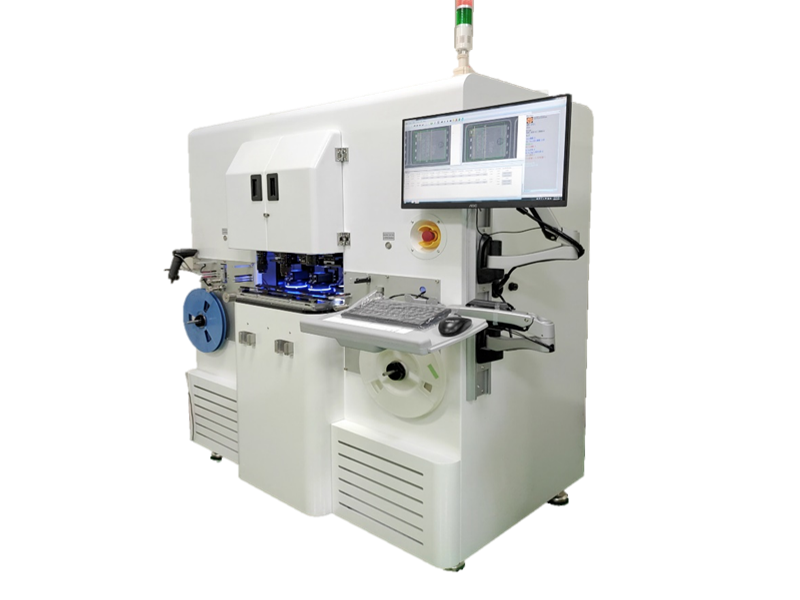
捲帶式晶片檢查機 Reel to Reel (FVI AOI)
【用途說明】
【特性說明】
| ● | 此設備可在半導體封裝製程中卷帶未拆封下,檢測晶片來料外觀缺陷。 |
【特性說明】
| ● | 外觀檢測,如空包, 刮傷, 髒污, 裂痕 。 |
| ● | 自動生成報表和標定缺陷晶片。 |
| ● | 支援SECS/GEM 。 |

Flux Jetting AOI
【用途說明】
【特性說明】
| ● | 針對 Flux噴塗後的檢查設備。 |
【特性說明】
| ● | Flux噴塗後檢查。 |
| ● | 可檢出Bump噴塗區及指定位置之覆蓋率。 |
| ● | 可檢出噴塗後Bump個數。 |

Die Bond AOI 後檢查機
【用途說明】
【特性說明】
| ● | 適用於載板/條狀基板的回焊前晶片與基板貼合後的視覺檢查。 |
【特性說明】
| ● | 即時監控與資料回饋。 |
| ● | 檢查晶片是否有位偏。 |
| ● | 晶片外觀檢查。 |

